TSMC в сотрудничестве с Broadcom объявили про выпуск платформы Chip-on-Wafer-on-Substrate (CoWoS) второго поколения. Она представляет собой 2,5D-технологию упаковки многокристальных чипов на кремниевом слое Interposer с использованием вертикальных промежуточных соединений TSV (through-silicon via).

Новая технология CoWoS позволяет использовать слой Interposer площадью до 1700 мм², что более чем в два раза превосходит возможности первого поколения (~ 800 мм²). Например, она позволяет разместить сложную 7-нм или 5-нм однокристальную систему и шесть стеков многослойной памяти HBM общим объёмом до 96 ГБ и пропускной способностью 2,7 ТБ/с.
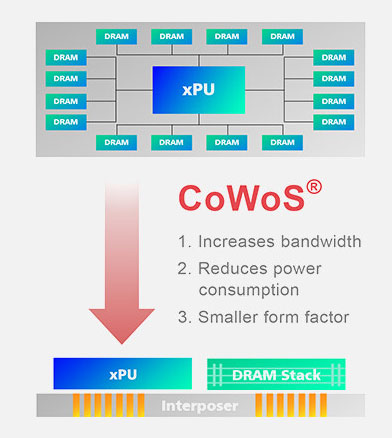
В первую очередь CoWoS будет востребована при создании многочиповых сборок для ресурсоемких рабочих нагрузок, включая машинное обучение, ИИ, оборудование для сетей 5G, энергоэффективные центры обработки данных и многое другое.
В этом сотрудничестве TSMC и Broadcom первая компания отвечала за производство, технологические процессы и разработку процесса сшивания маски, который и позволил увеличить площадь промежуточного слоя. В свою очередь, Broadcom предоставила SoC и многослойную память HBM, а также разработала общую конфигурацию многокристального чипа.

Реализация CoWoS на примере GPU Nvidia Pascal P100
CoWoS является частью портфеля TSMC под названием Wafer-Level System Integration (WLSI), который объединяет технологии упаковки сложных масштабируемых чипов. Помимо CoWoS в нем собраны технологии Integrated Fan Out (InFO) и System on Integrated Chips (SoIC), позволяющие внедрять инновации посредством разделения микросхем и системной интеграции.
Источник:
TechPowerUp
